
面对以上种种挑战,行业标杆企业已经搭建数智化平台,运用数智化手段进行全流程管控,尤其是良率分析方面,效果显著。
三、数智化良率分析技术
数智化良率分析是基于数智化平台的技术应用,主要由以下六个方面构成:
灵活规范的数据接入和存储
通过数智化平台将不同系统、不同接口、不同数据类型进行规范化整合,并满足未来数据的持续接入,使前期的数据清洗、整合更加高效。同时具备可扩展的大数据存储和计算功能。
面向对象的数据建模
在数智化平台上构建生产过程的数据模型,将业务部门在生产和改善活动中积累的大量设备、材料、工序等信息进行有效组织,全面表征产品生产过程,便于后续多维度细化分析。
数据模型的建立首先需要建立反应制造全过程的事实表,包含每批次的过站履历、芯片来自于哪片Wafer、贴到哪张Substrate、使用的Spare Part等;同时也要包含机台的工艺参数、机台检测数据等;然后在事实表的基础上进行多维度富化,增加各对象的动态、静态属性,为后续多维分析提供数据基础。鉴于不同企业数据颗粒度不同,可以结合自身数据能力按照敏捷迭代的思想分步实施。
灵活多维的数据分析
应用多维分析、可视技术,对多维数据模型进行切片、切块、上卷、下钻、转换等分析操作使得各部门能从各自关注的角度、不同侧面去观察、对比数据。满足组织灵活多变的数据分析需求。
精准的芯片定位分析
通过对多层堆叠产品内每个芯片的加工履历进行大数据追溯,识别芯片的系统性不良,定位不良所在的芯片,极大地缩短了异常分析时间,减少不良的损失。
简洁明了的大数据可视
通过场景驱动选择合适的图表进行可视化分析,除了经典的QC7大分析工具以外,还可以使用Wafer Map Gallery、Stack Map、累积概率图、热力图、箱线图等大数据可视分析工具。
下图通过Stack Map把Wafer Map Gallery进行叠图,从而使不明显的空间分布特征得到了强化。
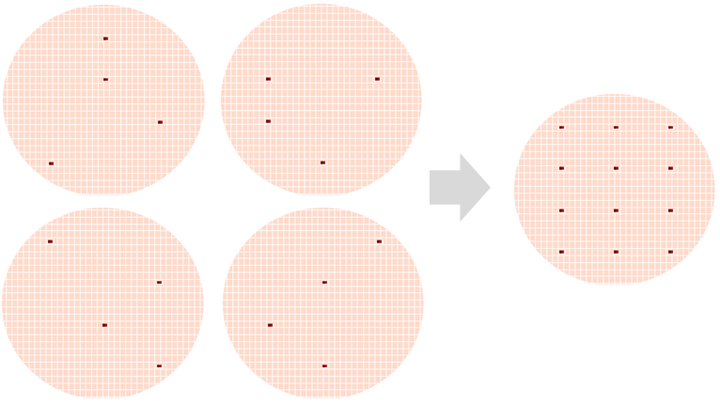
实时精准的AI智能
良率智能感知方面可以借助SPC、6Sigma等方法分析制造良率,实时识别良率异常波动情况。必要时可以利用时间序列回归ARIMA模型,根据历史数据预测未来良率走势,提前预警良率劣化趋势。





