
进入工业4.0时代,半导体制造数据在数量、种类、速度上有了质的飞越。同时快速发展的先进封装产品如系统级封装(SiP)、2.5D/3D封装,具有单个Package内芯片数量多、加工工艺复杂、成品价值高等特点,这促使越来越多的半导体封测企业更加聚焦封测产品良率,以此提升收益、增强竞争力。
半导体封测属于精密离散制造,融合了机械、材料、电子、图像识别、信息控制等先进技术,具有工艺流程复杂、加工精度高、加工产品脆弱等特点。标杆封测厂内每天有几百种产品,几千台设备同时生产,大量影响良率的因素同时存在。如何发现、定位不良,锁定不良根本原因是良率提升的关键,这就离不开专业的良率分析,所以良率的提升首先是从良率的分析开始。

一、封测良率分析概要
封测良率分析主要通过数据整合、指标计算、不良分析和锁定根因这几大步骤来完成,通过以上步骤输出良率提升的方案和推进计划形成产品良率的闭环管理。
1、数据整合
业务部门在产品生产和改善活动中积累了大量设备、材料、工序等信息,这些数据集中在MES,EES,Test Bin等系统中,由于系统供应商不同,格式也不一致,所以首先需要将数据进行规范化整合对齐,打通产品、测试、设备等数据链路。
2、指标计算
良率指标主要有以下几种:
- 单工程良率:FTY(First Time Yield)初期良率,以合格数 / 投产数计算
- 多工程良率:
. RTY(Rolled Throughput Yield)累积良率,以初期良率的乘积计算
. YNOR(Normalized Yield)标准化良率,以初期良率的几何平均计算
3、不良分析
包含数据分析和样品实物的失效分析。
数据分析
生产制造中的不良,从空间分布特征来看可以分为随机性不良和系统性不良。随机性不良与工艺、设备能力有关,一般在一个比较稳定的状态,产品之间的差异相对较小;系统性不良往往在工艺、设备不稳定或还不成熟时发生,其发生有很强的关联性,即在某种特定条件下有较高的发生率,常伴随着产品关联性、Spare Part关联性、区域关联性等。
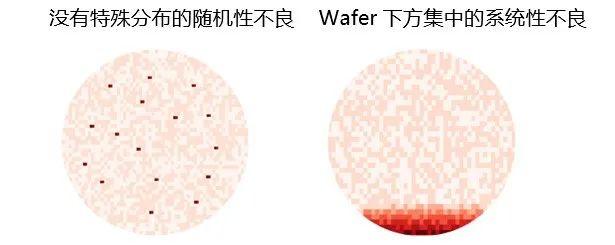
以往常用的数据分析,主要通过统计计算与图表可视化探索不良的规律性信息, 有集中性分析、相关性分析、聚类分析等常用的探索性分析方法。实际工作中还有很多特定场景,可以结合业务场景和算法特点灵活运用。
失效分析
失效分析是根据数据分析的结果,选择不良样品进行实物分析,包含EFA电性分析(Electrical Failure Analysis)和PFA物性分析((Physical Failure Analysis) 。通过精密分析设备进行微观分析,精确定位Package内不良的位置及具体形态。由于失效分析需要借助专业设备并由专门人员操作,所以只能选择样品少量分析。





